Establishing Correlations between UPW Quality and Particle Deposition on Silicon 300 mm Wafer
Date Published 2022 | Conference materials
Log in or Join UltraFacility to access this content
To access our resources you will need to be a member of UltraFacility, log in to your account or purchase a membership to view this content.
Already have an account? Log in
In the yield enhancement report 2021 there is a call for highly controlled deposition experiments to determine the particle deposition rate on the wafer compared to the known particle count in the ultrapure water (UPW) to gain better understanding about the contamination sources on-wafer. The goal of this collaborative study between Lam Research as a tool supplier and Ovivo Switzerland as an UPW engineering company is to investigate potential correlation between UPW quality form a full scale UPW plant and particle deposition on standard silicon 300 mm wafer.
Tags: YieldOrganic ContaminationUPW
Related content
Conference material | 2018
Development of an Online Urea Monitor for Ultrapure Water Production in Semiconductor Fabrication Plants
UPW journal archive | 2017
Can advanced oxidation technology help control TOC in semiconductor water?

Conference material | 2022
What is Known About Urea Control in UPW Systems?
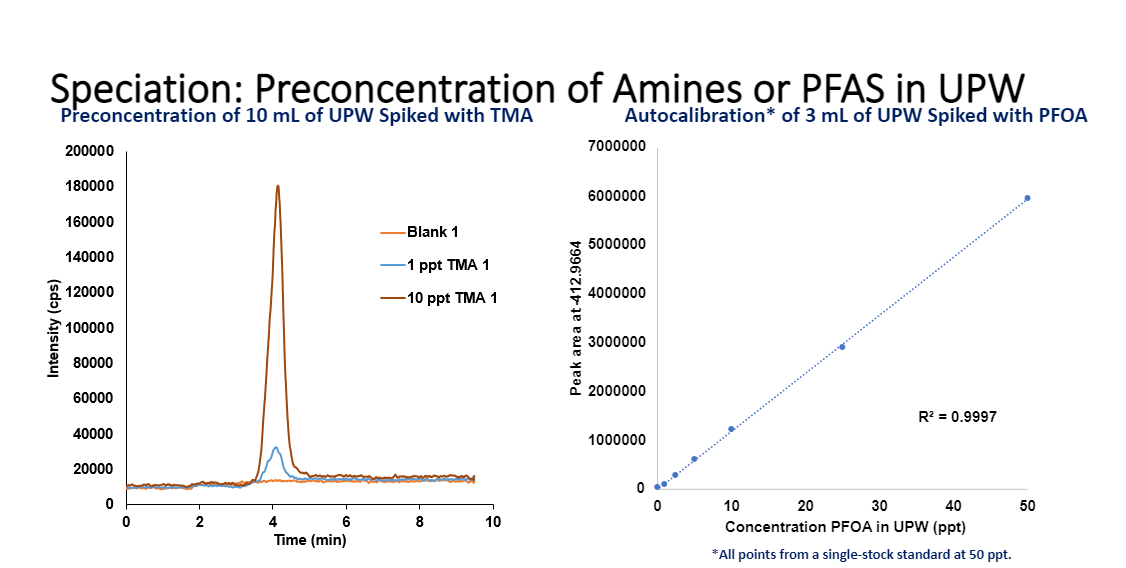
Conference material | 2022
Online Automated Determination of Organic Contaminants in Semiconductor Grade Chemicals
Back to results